Updates, ideas and resources
렛유인 반도체 공정 실습 2일차 (작성중)
목차
SEM / OM -> Dicing -> Photo Lithography
SEM / OM

[Optical Microscope]
OM은 빛을 사용하여 표본을 관찰하는 광학 현미경입니다.
-
장점:
- 낮은 비용
- 쉬운 사용
-
단점:
- 낮은 해상도
- 깊이 정보 부족
- 측정의 한계
[Scanning Electron Microscope]
SEM은 전자를 사용하여 샘플의 표면을 고해상도로 관찰하는 데 사용되는 현미경의 일종입니다.
-
장점:
- 고해상도 이미지
- 깊이 정보 제공
- 나노미터 스케일 관찰
-
단점:
- 비용 및 유지보수
- 전처리 필요
두 기기는 서로 보완적으로 사용되며, SEM이 높은 해상도로 표면을 관찰하고 깊이 정보를 제공하는 반면, OM은 일반적인 시각적 검사 및 대략적인 분석에 활용됩니다.
다만 이번 실습에서는 SEM을 쓸 정도로 미세한 패턴을 제작하지 않기에 OM을 활용하여 제작한 소자를 측정할 예정입니다.
Dicing (FAB : Etching Room)
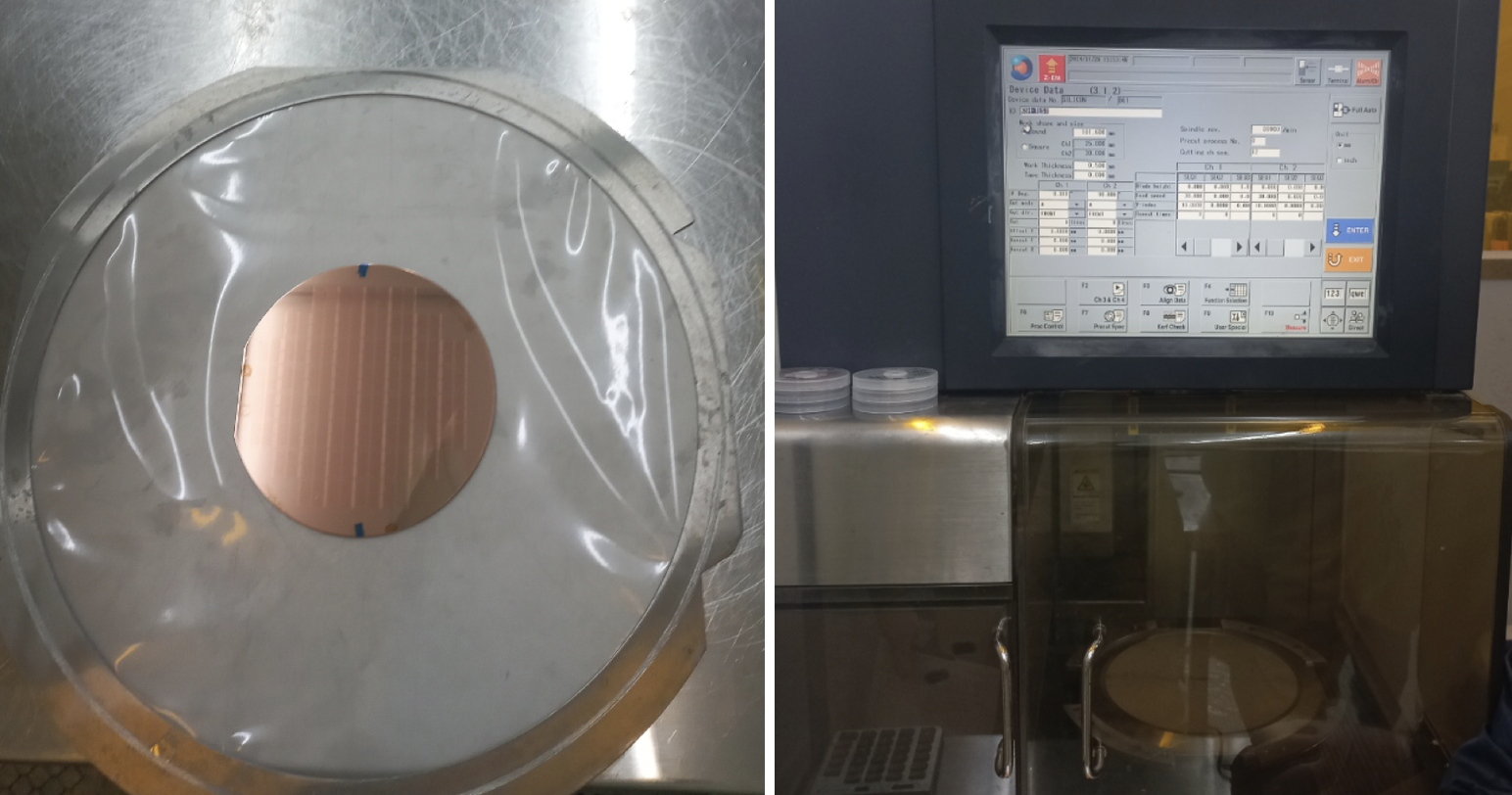
[Dicing?]
반도체 제조에서 웨이퍼는 세 번의 주요 변화를 거치며 최종적으로 개별 반도체 칩으로 나뉩니다. 그 중에서도 후공정 중 핵심적인 역할을 하는 다이싱은 반도체 칩의 구조와 패키지 형태에 직접적인 영향을 미치는 중요한 단계입니다 다이싱은 웨이퍼를 개별 칩으로 나누는 핵심 작업으로, 이 과정에서 육면체 형태의 Die가 만들어집니다.
다이싱은 시간이 지남에 따라 스크라이브 다이싱, 블레이드 다이싱, 레이저 다이싱, 플라즈마 다이싱 순으로 발전하였습니다. 그 중 우리가 이번 실습에서 다루어볼 방법은 블레이드를 이용한 방법입니다.
블레이드 다이싱은 반도체 제조에서 웨이퍼를 작은 다이로 나누는 핵심 단계 중 하나로, 스크라이브 다이싱에서 발전된 방식 중 하나입니다.
이 방법은 블레이드를 2~3번 연속으로 사용하여 웨이퍼를 자르는데 스크라이브 다이싱에서 발생하는 문제 중 하나인 칩핑 문제를 보완한 방식입니다.
장점
- 고효율 생산
- 저비용
- 간단한 프로세스
단점
- 칩핑 발생 가능
- 미세한 공정에서 사용 불가
- 손상 가능성

이번 실습은 아래와 같은 순서대로 공정이 진행되었습니다.
Process
- Wafer Taping
- Aligning
- Dicing
- Die Separation
- Cleaning
- Inspection
웨이퍼나 다이의 외부 데미지로 손상되는 것을 방지하기 위해, 사전에 웨이퍼에 접착 테이프를 부착합니다. 그리고 오른쪽 사진처럼 다이싱 장비에 넣고 정렬시키고 알맞은 파라미터값을 입력한 후 공정을 진행합니다. 공정이 완료되면 위 오른쪽 사진과 같은 결과물을 얻게 됩니다.
Photo Lithography(Via Hole) (FAB : Litho Room)
이번 실습에서는 mems 수동소자 중 하나인 인덕터를 만들 계획이다.
작성 중...